在微尺寸 PCB 的全生命周期中,装配焊接是仅次于设计和制造的高风险失效环节。微型元器件、小微焊盘,对焊接工艺的精度、温度、设备要求极高。哪怕是一个微小的焊接参数偏差,都会引发虚焊、连锡、焊盘脱落、元器件损伤等问题,直接导致 PCB 失效。
想要解决装配焊接失效,首先要优化焊锡膏与钢网设计。焊锡膏选择无铅、低残留、适合微型器件的焊锡膏,颗粒直径选择 3–5 号粉,颗粒更细小,能均匀覆盖微型焊盘,避免因颗粒过大导致漏印、虚焊。钢网设计是控制焊锡量的关键,也是防控连锡、虚焊的核心。1. 钢网厚度:微尺寸 PCB 的钢网厚度优先选择 0.08–0.1mm,相比于常规 0.12mm 的钢网,更适合微型焊盘。2. 开孔优化:0201、01005 器件的焊盘,钢网开孔采用内缩设计,开孔面积比焊盘面积小 10%–15%,避免焊锡膏过多导致连锡。对于 BGA、QFN 等封装的微型芯片,钢网开孔采用网格状或分体式开孔,保证焊锡膏均匀分布。禁止在钢网上开设过大的开孔,防止焊锡膏坍塌。钢网使用前,进行清洗和检测,避免钢网堵塞、破损。
其次是贴装工艺的精准管控。微尺寸元器件的贴装,必须使用高精度贴片机,贴装精度要达到 ±0.02mm 以内。贴装前,对元器件进行烘干处理,避免元器件受潮,焊接时产生爆米花效应,损伤元器件和 PCB。贴装过程中,设置合理的贴装压力,压力过大,会压裂微型元器件和薄型 PCB;压力过小,元器件无法和焊锡膏充分接触,引发虚焊。贴装完成后,在回流焊前,进行 AOI 光学检测,检查元器件的贴装位置、偏移情况、有无缺件、错件。发现问题,及时修正,避免不合格品进入回流焊环节。
核心环节是回流焊温度曲线的专项优化,这是防控热应力失效、焊盘脱落的关键。微尺寸 PCB 的焊盘和元器件热容量小,不能沿用常规 PCB 的温度曲线,必须单独做温度 Profiling 测试。1. 预热区:延长预热时间,控制升温速率在 1–2℃/ 秒,避免升温过快,产生热冲击。预热阶段,让整个 PCB 和元器件的温度均匀上升,挥发焊锡膏中的助焊剂溶剂。2. 恒温区:保证足够的恒温时间,让助焊剂充分活化,清除焊盘和元器件引脚的氧化层。3. 回流区:严格控制峰值温度和回流时间。无铅焊锡膏的峰值温度控制在 240–245℃,回流时间控制在 30–60 秒。避免峰值温度过高,导致焊盘碳化、元器件损伤;避免回流时间过长,加剧热应力。4. 冷却区:控制冷却速率,采用强制风冷,让 PCB 快速均匀冷却,减少元器件和 PCB 之间的热膨胀差异,降低热应力。
焊接完成后,完善的检测与返修管控必不可少。首件产品必须进行 X-Ray 检测,检查 BGA、QFN、微孔的焊接情况,确认无气泡、虚焊、短路。批量产品采用 AOI 全检,筛选出虚焊、连锡、元器件偏移的板件。微尺寸 PCB 的返修,难度远高于常规 PCB,必须制定严格的返修规范。1. 返修工具:使用微型热风枪、精密烙铁,配备显微返修台,方便精准操作。2. 返修温度:返修温度略低于回流焊峰值温度,避免长时间加热,损伤周边元器件和焊盘。3. 返修限制:同一位置的返修次数不超过 2 次,多次返修会导致焊盘脱落、基板分层。返修完成后,再次进行 AOI 和功能测试,合格后方可流入下一道工序。
除此之外,还要做好装配环境管控。微尺寸 PCB 装配车间,必须是防静电、无尘车间。静电会击穿微型芯片和敏感元器件,灰尘会导致焊接不良。操作人员必须穿戴防静电服、防静电手环,使用防静电工装夹具。同时,控制车间的温湿度,温度控制在 23±3℃,湿度控制在 45%–65%,避免湿度过高导致焊锡膏吸潮,影响焊接质量。
微尺寸 PCB 的装配焊接,是 “差之毫厘,谬以千里”。作为工程师,要深入产线,结合产品特性,联合工艺工程师、产线操作人员,共同优化焊接工艺。从焊锡膏、钢网、贴装、回流焊到检测返修,每一个环节都做到精准管控,才能从根本上解决焊接失效问题,让微尺寸 PCB 在装配环节就拥有可靠的品质。






 欢迎来到深圳市诚驰电路科技有限公司官网!
欢迎来到深圳市诚驰电路科技有限公司官网! 关注微信
关注微信 网站地图
网站地图 English
English


 廖工:18129931046
廖工:18129931046


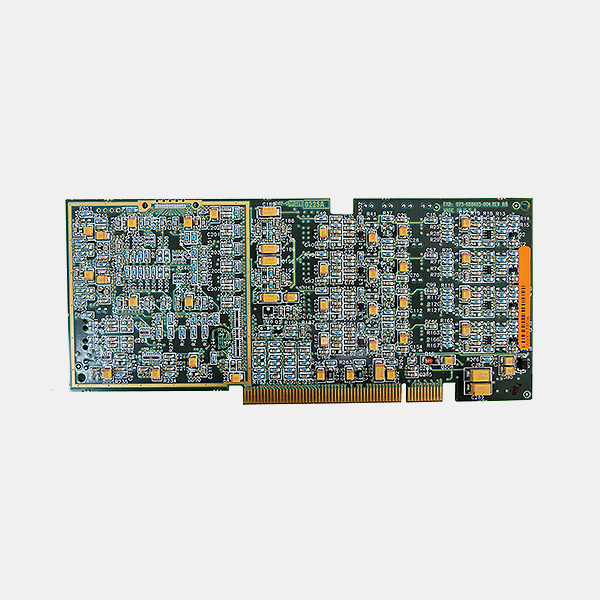











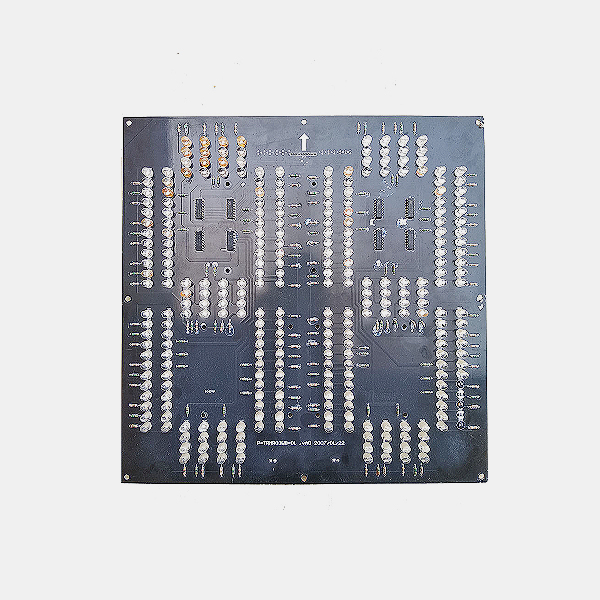

















 扫码添加微信(林经理)
扫码添加微信(林经理)
 扫码添加微信(廖 工)
扫码添加微信(廖 工)